热门检测
最新项目
GB/T24578-2024半导体晶片表面金属沾污的测定 全反射X射线荧光光谱法
发布时间:2024-12-24
本文件描述了半导体镜面晶片表面深度为5nm以内金属元素的全反射X射线荧光光谱(TXRF)测试方法。
本文件适用于硅、绝缘衬底上的硅(SOI)、锗、碳化硅、蓝宝石、砷化镓、磷化铟、锑化镓等单晶抛光片或外延片表面金属沾污的测定,尤其适用于晶片清洗后自然氧化层或经化学方法生长的氧化层中沾污元素面密度的测定,测定范围:109atoms/cm2~1015atoms/cm2。
本文件规定的方法能够检测周期表中原子序数16(S)~92(U)的元素,尤其适用于钾、钙、钛、钒、铬、锰、铁、钴、镍、铜、锌、砷
注意:因业务调整,暂不接受个人委托测试望见谅。
标准中涉及的相关检测项目
标准《GB/T 24578-2024 半导体晶片表面金属沾污的测定 全反射X射线荧光光谱法》主要涉及的内容包括以下几个方面:
检测项目:- 半导体晶片表面金属元素的种类和浓度检测。
- 金属污染物的分布和均匀性分析。
- 金属污染物对晶片表面特性的影响评估。
该标准主要采用全反射X射线荧光光谱法(TXRF),该方法具有高灵敏度、高选择性和非破坏性的优点,适用于微量金属元素的检测。
具体检测流程包括:
- 样品制备:清洗和处理半导体晶片以去除表面无关物质。
- 仪器调试:校准全反射X射线荧光光谱仪,确保其处于最佳工作状态。
- 测试分析:将样品放置于仪器中进行测量,获取不同金属元素的谱线和强度信息。
- 数据处理:根据标准曲线和仪器校准结果,计算各金属元素的浓度。
- 硅晶圆等半导体材料。
- 集成电路制造过程中使用的半导体基片。
- 其他相关高精度电子元件和芯片。
通过该标准的检测方法,可以有效评估半导体晶片制造过程中的金属污染情况,从而为提升产品质量和可靠性提供依据。
GB/T24578-2024半导体晶片表面金属沾污的测定 全反射X射线荧光光谱法 的简介
本文件描述了半导体镜面晶片表面深度为5nm以内金属元素的全反射X射线荧光光谱(TXRF)测试方法。本文件适用于硅、绝缘衬底上的硅(SOI)、锗、碳化硅、蓝宝石、砷化镓、磷化铟、锑化镓等单晶抛光片或外延片表面金属沾污的测定,尤其适用于晶片清洗后自然氧化层或经化学方法生长的氧化层中沾污元素面密度的测定,测定范围:109atoms/cm2~1015atoms/cm2。
本文件规定的方法能够检测周期表中原子序数16(S)~92(U)的元素,尤其适用于钾、钙、钛、钒、铬、锰、铁、钴、镍、铜、锌、砷、钼、钯、银、锡、钽、钨、铂、金、汞和铅等金属元素。
GB/T24578-2024半导体晶片表面金属沾污的测定 全反射X射线荧光光谱法 的基本信息
标准名:半导体晶片表面金属沾污的测定 全反射X射线荧光光谱法
标准号:GB/T 24578-2024
标准类别:
发布日期: 2024-07-24
实施日期:
标准状态:即将实施
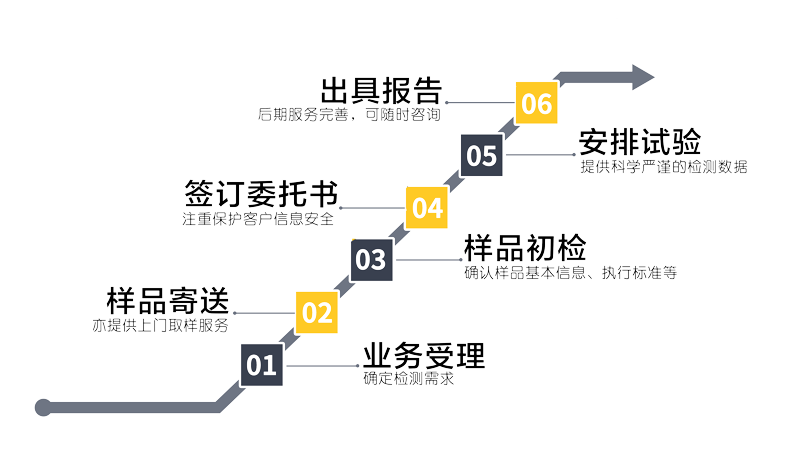
合作客户展示

部分资质展示
