氮化镓外延片发光性能检测
发布时间:2025-06-03
检测项目发光峰值波长、半高宽(FWHM)、积分发光强度、内量子效率(IQE)、外量子效率(EQE)、辐射复合寿命、非辐射复合寿命、载流子浓度/迁移率(霍尔效应)、缺陷态密度(DLTS/深能级瞬态谱)、位错密度(阴极荧光/CL)、表面粗糙度(AFM)、薄膜厚度(椭圆偏振/反射谱)、应力/应变状态(拉曼光谱)、组分均匀性(EDS/mapping)、掺杂浓度(SIMS)、界面态密度(C-V)、激子结合能、带隙能量、黄光带(YL)强度比、紫外带(UV)强度比、热猝灭特性、光衰特性(老化测试)、空间均匀性(mapp
注意:因业务调整,暂不接受个人委托测试望见谅。
检测项目
发光峰值波长、半高宽(FWHM)、积分发光强度、内量子效率(IQE)、外量子效率(EQE)、辐射复合寿命、非辐射复合寿命、载流子浓度/迁移率(霍尔效应)、缺陷态密度(DLTS/深能级瞬态谱)、位错密度(阴极荧光/CL)、表面粗糙度(AFM)、薄膜厚度(椭圆偏振/反射谱)、应力/应变状态(拉曼光谱)、组分均匀性(EDS/mapping)、掺杂浓度(SIMS)、界面态密度(C-V)、激子结合能、带隙能量、黄光带(YL)强度比、紫外带(UV)强度比、热猝灭特性、光衰特性(老化测试)、空间均匀性(mapping)、时间分辨光谱(TRPL)、变温PL光谱、变功率PL光谱、偏振相关发光特性、吸收系数、反射率/透射率、俄歇复合系数。
检测范围
蓝宝石衬底GaN外延片、SiC衬底GaN外延片、硅衬底GaN外延片(硅基GaN)、GaN自支撑衬底同质外延片、AlGaN/GaN超晶格外延片、InGaN/GaN多量子阱(MQW)外延片、AlN缓冲层/GaN外延片、掺杂型GaN外延片(n型/p型/Mg掺杂/Si掺杂)、非故意掺杂(u-GaN)外延片、低维GaN纳米结构外延片(纳米线/量子点)、图案化衬底GaN外延片(PSS)、厚膜GaN外延片(>10μm)、薄膜GaN外延片(<2μm)、异质结结构(GaN-on-Si,GaN-on-Sapphire等)、HVPE法生长GaN外延片、MOCVD法生长GaN外延片、MBE法生长GaN外延片、高阻GaN外延片、半绝缘GaN外延片、梯度组分AlGaN外延片、InAlGaN四元合金外延片、GaN基HEMT结构外延片(含势垒层)、微盘结构GaN外延片、V形坑缺陷调控GaN外延片、选择性区域生长(SAG)GaN外延片、掩埋式异质结GaN外延片、多孔GaN模板上再生长外延片。
检测方法
光致发光光谱法(PL):使用特定波长激光器(如325nmHe-Cd激光器或266nm固体激光器)激发样品,通过高分辨率光谱仪收集并分析其自发发射光谱。用于测定发光峰值波长、半高宽(FWHM)、积分强度及黄光带(YL)/紫外带(UV)强度比,评估材料带隙结构及缺陷态密度。
时间分辨光致发光法(TRPL):采用超短脉冲激光激发样品,利用单光子计数或条纹相机技术记录荧光衰减曲线。通过拟合衰减动力学过程获取辐射与非辐射复合寿命,直接计算内量子效率(IQE),是评估材料质量与载流子动力学的核心手段。
电致发光测试法(EL):在外延片上制备透明电极或微电极结构,施加正向偏压注入载流子。通过显微成像系统和高灵敏度探测器获取EL光谱及空间分布图(mapping),评估器件有源区效率及均匀性。
变温光致发光法(Temperature-dependentPL):在低温恒温器(4K-500K)环境中进行PL测试。通过分析峰值能量随温度变化的“S形”曲线及热猝灭行为,研究局域化效应深浅和激活能。
阴极荧光光谱法(CL):在扫描电子显微镜(SEM)中利用电子束激发样品表面微小区域(分辨率可达纳米级),收集发射光信号。结合SEM形貌像进行定位分析,用于表征位错等缺陷相关的非辐射复合中心分布。
霍尔效应测试(HallEffect):采用范德堡法在特定温度下测量样品的电阻率、载流子浓度和迁移率。需制备欧姆接触点阵电极,为分析材料电学性能与发光效率关联提供基础数据。
深能级瞬态谱法(DLTS):通过电容瞬态响应分析半导体中深能级陷阱的浓度和俘获截面。需制备肖特基势垒或PN结结构,用于定量表征影响复合效率的深能级缺陷。
X射线衍射法(XRD):高分辨率XRD(如HRXRD,ReciprocalSpaceMapping)精确测定晶格常数和应变状态。摇摆曲线半高宽反映晶体质量与位错密度。
原子力显微镜(AFM):接触或轻敲模式扫描样品表面形貌,获取均方根粗糙度(RMS)和位错露头点信息。
二次离子质谱(SIMS):通过离子束溅射逐层剥离样品并分析溅射离子成分,实现掺杂元素(Si,Mg等)深度分布及杂质浓度的精确测量。
检测标准
GB/T38958-2020氮化镓单晶位错密度的测定阴极荧光光谱法
SJ/T11900-2023氮化镓单晶衬底及外延层结晶质量测试方法
SJ/T11901-2023氮化镓材料中载流子浓度的测试拉曼光谱法
IEC62969-5:2021Semiconductordevices-Micro-electromechanicaldevices-Part5:Measurementmethodsofgalliumnitridebasedmaterials(Opticalproperties)
ASTMF3128-19StandardGuideforEvaluatingOpticalPropertiesofElectronicMaterialsUsingPhotoluminescence
JISC8936:2019Measurementmethodsforinternalquantumefficiencyofinorganiclight-emittingdiodewafersusingphotoluminescence
GB/T35031.3-2018半导体材料及电子学特性测量方法第3部分:深能级瞬态谱法
SJ/T11495-2015Ⅲ-Ⅴ族化合物半导体材料光致发光测试方法
ISO18554:2016Surfacechemicalanalysis-Electronspectroscopies-Proceduresforidentifying,estimatingandcorrectingforunintendeddegradationbyX-raysinamaterialundergoinganalysisbyX-rayphotoelectronspectroscopy(涉及表面态对发光影响)
GB/T32281-2015半导体材料中杂质元素的测定二次离子质谱法
检测仪器
显微共聚焦光致发光光谱系统:集成激光光源(连续/脉冲)、显微物镜(紫外波段优化)、高分辨率光谱仪(焦长≥750mm)及液氦闭循环低温恒温台(4K-500K)。核心用于微区PL/TRPL测试及Mapping成像。
电致发光测试平台:包含精密探针台(可加热/制冷)、低噪声电流源表(SourceMeterUnit)、显微成像透镜组及高灵敏度光谱仪(CCD/InGaAs探测器)。支持微区EL光谱采集及效率分析。
时间分辨荧光光谱仪:采用飞秒/皮秒脉冲激光器(如钛宝石激光器)、单光子雪崩二极管(SPAD)或条纹相机作为探测器系统。时间分辨率可达皮秒量级,专用于TRPL寿命测量。
低温阴极荧光系统(CL):集成于场发射扫描电子显微镜(FE-SEM),配备液氦冷台(最低5K)及高传输效率光收集系统(椭球镜/光纤耦合)。实现纳米尺度缺陷发光定位分析。
霍尔效应测试系统:配备高磁场电磁铁(≥1T)、精密恒流源/纳伏表及真空低温杜瓦(77K-400K)。采用范德堡配置自动测量电阻率/载流子参数。
深能级瞬态谱仪(DLTS):包含快速电容计(1MHz)、程控温控系统(80K-500K)及脉冲发生器。通过瞬态信号傅里叶变换分析深能级陷阱特征参数。
高分辨率X射线衍射仪(HRXRD):配置四晶单色器与多通道探测器(如PIXcel3D),具备ω-2θ扫描与倒易空间映射功能。精确测定晶格应变与位错密度。
原子力显微镜(AFM):采用轻敲模式(TappingMode)或接触模式(ContactMode),配备高刚性悬臂探针(弹性常数~40N/m)。用于亚纳米级表面形貌与粗糙度表征。
傅里叶变换红外光谱仪(FTIR):配备液氮冷却MCT探测器及显微附件。用于透射/反射模式下的光学常数(吸收系数/折射率)测量。
二次离子质谱仪(SIMS):采用磁扇型或飞行时间型质谱仪(TOF-SIMS),配置Cs+/O+双离子源溅射枪。实现ppb级杂质深度剖析与掺杂浓度标定。
检测服务范围
1、指标检测:按国标、行标及其他规范方法检测
2、仪器共享:按仪器规范或用户提供的规范检测
3、主成分分析:对含量高的组分或你所规定的某种组分进行5~7天检测。
4,样品前处理:对产品进行预处理后,进行样品前处理,包括样品的采集与保存,样品的提取与分离,样品的鉴定以及样品的初步分析,通过逆向剖析确定原料化学名称及含量等共10个步骤;
5、深度分析:根据成分分析对采购的原料标准品做准确的定性定量检测,然后给出参考工艺及原料的推荐。最后对产品的质量控制及生产过程中出现问题及时解决。
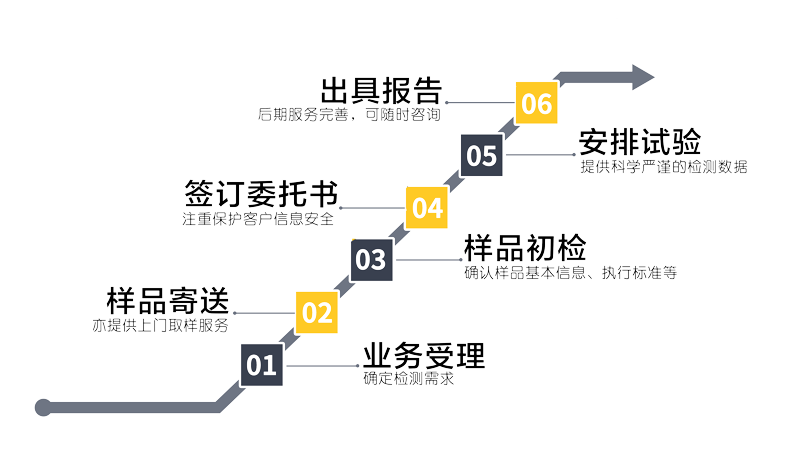
合作客户展示

部分资质展示







