芯片失效分析先进工艺筛片分析(DPA)检测
发布时间:2025-06-12
芯片失效分析中的先进工艺筛片分析(DPA)检测是通过系统性检查半导体器件的结构、材料和电性能,识别失效模式如分层、开裂或污染,确保可靠性并支持工艺优化,检测要点包括高分辨率成像、元素分析和无损测试。
注意:因业务调整,暂不接受个人委托测试望见谅。
检测项目
光学显微镜检查:表面缺陷目视分析,分辨率优于0.5μm,放大倍率50x-1000x
扫描电子显微镜(SEM)分析:微观形貌成像,放大范围10x-300,000x,分辨率达1nm
透射电子显微镜(TEM)分析:原子级结构表征,加速电压80-300kV,点分辨率0.2nm
X射线透视成像:内部结构无损检测,分辨率10μm,电压范围20-160kV
声学显微镜检查:分层缺陷探测,频率范围10-230MHz,扫描精度5μm
聚焦离子束(FIB)切割:精密截面制备,离子束电流1pA-65nA,定位精度1μm
能谱分析(EDS):元素组分定性定量,检测限0.1wt%,能量分辨率129eV
二次离子质谱(SIMS):痕量杂质分析,深度分辨率5nm,检出限1ppm
电性能测试:I-V特性测量,电压范围±200V,电流精度0.1%
热分析:热膨胀系数评估,温度范围-150°C至600°C,升温速率0.1-20°C/min
红外显微镜检查:热分布成像,波长范围3-5μm,温度分辨率0.1°C
拉曼光谱分析:材料结构鉴定,光谱分辨率1cm⁻¹,激光波长532nm
离子研磨制备:样品抛光处理,离子能量1-8keV,表面粗糙度<0.1μm
封装完整性测试:密封性验证,氦检漏率<1×10⁻⁸ atm·cc/s
焊接点强度测试:剪切力测量,力范围0-50kgf,精度±1%
检测范围
集成电路(IC)芯片:逻辑和微处理器单元,用于计算控制应用
存储器件:DRAM和Flash存储器,支持数据存储功能
微电子机械系统(MEMS):加速度传感器和陀螺仪,用于运动检测
射频器件:功率放大器和滤波器,适用于通信系统
功率半导体:IGBT和MOSFET,用于电能转换控制
光电器件:LED和激光二极管,涉及光学信号处理
封装材料:环氧树脂和陶瓷基板,提供机械保护
焊接点:焊球和凸点,实现电气互连
互连线:铜线和铝线,构成电路连接路径
钝化层:SiN和SiO2薄膜,防止环境腐蚀
粘合线:金线和铜线,用于芯片键合
基板材料:FR4和陶瓷,支撑电子组件
热界面材料:导热膏和垫片,优化散热性能
保护涂层:聚酰亚胺和环氧,增强耐久性
检测标准
依据MIL-STD-883 Method 5009进行破坏性物理分析
ISO 14647微电子学失效分析通用规范
GB/T 2828.1计数抽样检验程序
ASTM E3金相试样制备标准指南
JEDEC JESD22-A101稳态温度湿度偏置测试
IEC 60749半导体器件环境试验方法
GB/T 4937半导体器件机械和气候试验
IPC TM-650印制板测试方法
SEMI M1硅单晶抛光片规范
DIN EN ISO 9001质量管理系统要求
ANSI/ESD S20.20静电放电控制程序
GB/T 26125电子电气产品有害物质检测
ISO 17025检测和校准实验室能力要求
检测仪器
高分辨率扫描电子显微镜:提供纳米级表面成像,用于缺陷定位和形貌分析
精密聚焦离子束系统:实现亚微米级样品切割,用于TEM薄片制备和电路修复
多轴X射线检测仪:执行无损内部扫描,用于焊接点空洞和裂纹识别
超声波声学显微镜:探测内部界面缺陷,用于分层和脱粘评估
能谱分析仪:进行元素成分定性定量,用于污染源和材料组成鉴定
热性能测试台:测量热膨胀和应力分布,用于热失效机制研究
电性参数测量系统:分析I-V和C-V特性,用于开路短路故障诊断
红外热成像仪:监控温度场变化,用于热点和热管理优化
检测服务范围
1、指标检测:按国标、行标及其他规范方法检测
2、仪器共享:按仪器规范或用户提供的规范检测
3、主成分分析:对含量高的组分或你所规定的某种组分进行5~7天检测。
4,样品前处理:对产品进行预处理后,进行样品前处理,包括样品的采集与保存,样品的提取与分离,样品的鉴定以及样品的初步分析,通过逆向剖析确定原料化学名称及含量等共10个步骤;
5、深度分析:根据成分分析对采购的原料标准品做准确的定性定量检测,然后给出参考工艺及原料的推荐。最后对产品的质量控制及生产过程中出现问题及时解决。
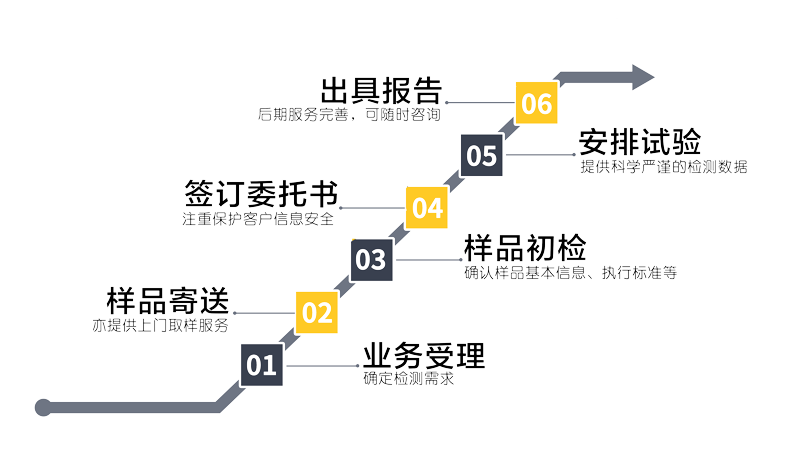
合作客户展示

部分资质展示







