热门检测
最新项目
GB/T31225-2014椭圆偏振仪测量硅表面上二氧化硅薄层厚度的方法
发布时间:2024-12-21
本标准给出了使用连续变波长、变角度的光谱型椭圆偏振仪测量硅表面上二氧化硅薄层厚度的方法。
本标准适用于测试硅基底上厚度均匀、各向同性、10nm~1000nm厚的二氧化硅薄层厚度,其他对测试波长处不透光的基底上单层介电薄膜样品厚度测量可以参考此方法。
注意:因业务调整,暂不接受个人委托测试望见谅。
标准中涉及的相关检测项目
标准《GB/T 31225-2014 椭圆偏振仪测量硅表面上二氧化硅薄层厚度的方法》是一项针对椭圆偏振测量方法的国家标准,其相关的检测项目、检测方法及涉及的产品如下:
检测项目:
1. 薄层厚度测量:主要检测的是硅表面上二氧化硅薄层的厚度。
2. 薄膜界面质量评估:通过测量评估薄膜与硅界面的均匀性和附着力。
3. 折射率与消光系数测量:二氧化硅薄层的光学常数的测定。
检测方法:
1. 椭圆偏振法:通过测量偏振光在经过薄膜时的振幅变化和相位变化来计算薄层的厚度及光学性质。
2. 数据拟合法:基于椭圆偏振数据建立薄膜的理论模型,通过拟合实验数据获得参数值。
3. 误差分析:利用标准砂片进行测量误差评估,提高测量精度。
涉及产品:
1. 硅晶圆:用于半导体行业的单晶硅片和多晶硅片。
2. 集成电路及芯片:生产过程中需要测量二氧化硅薄膜的厚度。
3. 光电器件:如光学元件表面处理需要精确控制薄膜厚度。
这项标准广泛应用在微电子制造、材料科学研究等领域,对于硅表面上二氧化硅薄膜的测量提供了科学依据和技术支持。
GB/T31225-2014椭圆偏振仪测量硅表面上二氧化硅薄层厚度的方法 的简介
本标准给出了使用连续变波长、变角度的光谱型椭圆偏振仪测量硅表面上二氧化硅薄层厚度的方法。本标准适用于测试硅基底上厚度均匀、各向同性、10nm~1000nm厚的二氧化硅薄层厚度,其他对测试波长处不透光的基底上单层介电薄膜样品厚度测量可以参考此方法。
GB/T31225-2014椭圆偏振仪测量硅表面上二氧化硅薄层厚度的方法 的基本信息
标准名:椭圆偏振仪测量硅表面上二氧化硅薄层厚度的方法
标准号:GB/T 31225-2014
标准类别:
发布日期: 2014-09-30
实施日期:
标准状态:现行
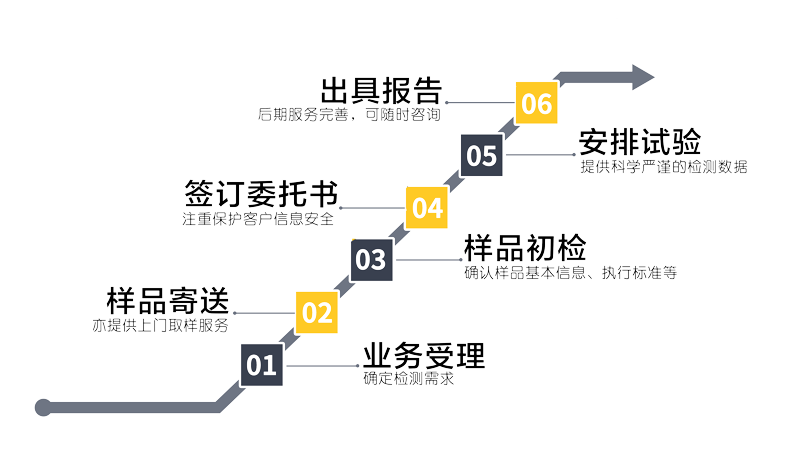
合作客户展示

部分资质展示
