等离子刻蚀机检测
发布时间:2025-07-03
等离子刻蚀机检测聚焦设备关键性能指标与工艺稳定性验证,涵盖等离子体特性、刻蚀均匀性、残留物控制等核心参数。通过国际标准化的测试流程,确保设备在半导体制造、纳米器件加工等领域的工艺重复性和缺陷控制能力满足精密加工要求。
注意:因业务调整,暂不接受个人委托测试望见谅。
检测项目
等离子体密度:射频功率0-5000W范围内测量离子浓度,精度±5%
刻蚀均匀性:300mm晶圆表面65点扫描测试,偏差≤±3%
选择比检测:SiO₂/Si材料刻蚀速率比测量,精度0.01
残留气体分析:质谱仪监测反应腔体F-/Cl-离子浓度
电极温度稳定性:-50℃至300℃温控系统响应测试
射频匹配效率:13.56MHz匹配网络反射率<1%
颗粒污染计数:0.1-5μm粒径分布统计,每晶圆≤20颗粒
侧壁角度测量:SEM成像分析刻蚀剖面89°-91°垂直度
刻蚀终点判定:OES光谱556nm特征波长检测灵敏度0.1%
真空泄漏率:10-7Torr基础压力下泄漏<5×10-9mbar·L/s
反应腔体洁净度:XPS表面分析C/O原子比<0.05
气体流量精度:MFC控制误差±0.1sccm
检测范围
硅基刻蚀设备:逻辑芯片栅极刻蚀工艺验证
介质刻蚀系统:TSV通孔侧壁粗糙度控制
化合物半导体设备:GaN/AlGaN异质结构刻蚀
MEMS制造设备:硅深槽刻蚀深宽比50:1验证
光掩模刻蚀机:Cr/MoSi薄膜选择比测试
Ⅲ-Ⅴ族材料刻蚀:InP激光器结构斜面控制
金属互连刻蚀:Cu/TaN阻挡层界面分析
OLED显示刻蚀:RGB像素阵列均匀性检测
功率器件刻蚀:SiC沟槽栅极形貌表征
磁存储器刻蚀:CoFeB/Ta叠层侧壁角度控制
生物芯片刻蚀:微流道深度一致性测试
光伏电池刻蚀:PERC电池背钝化层开口检测
检测标准
SEMI E10-1101设备可靠性验证标准
ASTM F1391等离子体密度测试规范
ISO 14644-1洁净室颗粒控制标准
GB/T 30276-2013半导体设备真空检测方法
IEC 60749-25半导体器件机械应力试验
JESD22-A110D温度循环测试标准
GB/T 26111-2010微电子工艺设备通用规范
SEMI F47-0706电压暂降抗扰度标准
ISO 9013热切割质量评定标准
ASTM E112晶粒度测定方法
检测仪器
四极质谱仪:实时监测反应腔体气体成分,分辨率0.1amu
激光干涉终点探测器:1550nm波长刻蚀深度实时监控,精度±2nm
扫描电子显微镜:15kV加速电压下刻蚀形貌三维重构
椭偏仪:薄膜厚度测量范围1-2000nm,精度±0.1nm
原子力显微镜:表面粗糙度Ra检测分辨率0.1nm
辉光放电光谱仪:等离子体激发态原子浓度分析
表面轮廓仪:台阶高度测量范围0.5nm-1mm
残余气体分析仪:10-10Torr检出限真空系统检测
射频功率计:0.1-100MHz频率范围功率测量误差±1%
热像仪:电极温度分布成像,空间分辨率0.1℃
检测服务范围
1、指标检测:按国标、行标及其他规范方法检测
2、仪器共享:按仪器规范或用户提供的规范检测
3、主成分分析:对含量高的组分或你所规定的某种组分进行5~7天检测。
4,样品前处理:对产品进行预处理后,进行样品前处理,包括样品的采集与保存,样品的提取与分离,样品的鉴定以及样品的初步分析,通过逆向剖析确定原料化学名称及含量等共10个步骤;
5、深度分析:根据成分分析对采购的原料标准品做准确的定性定量检测,然后给出参考工艺及原料的推荐。最后对产品的质量控制及生产过程中出现问题及时解决。
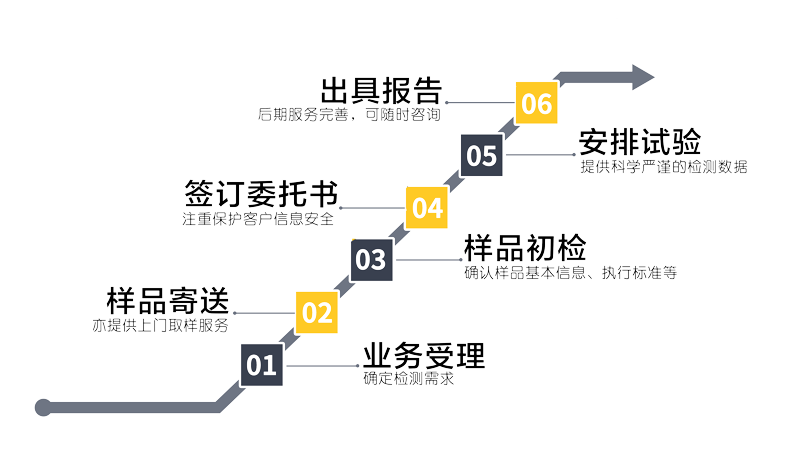
合作客户展示

部分资质展示






