集成电路封装框架规范检测
发布时间:2025-05-30
检测项目成分分析、硬度测试、拉伸强度、弯曲强度、热膨胀系数、导热系数、表面粗糙度、镀层厚度、引脚共面度、引脚间距精度、焊盘平整度、封装体翘曲度、气密性测试、湿气敏感等级(MSL)、温度循环耐受性、高温存储寿命、湿热老化试验、盐雾腐蚀试验、离子污染度、绝缘电阻、导通电阻、介电强度、信号完整性分析、X射线空洞率检查、超声波扫描缺陷探测、金线键合强度、胶体固化度评估、塑封料玻璃化转变温度(Tg)、吸湿率测定、可焊性测试检测范围QFP封装框架、BGA基板框架、CSP封装支架、LGA载板结构、SOP引线框架、DIP
注意:因业务调整,暂不接受个人委托测试望见谅。
检测项目
成分分析、硬度测试、拉伸强度、弯曲强度、热膨胀系数、导热系数、表面粗糙度、镀层厚度、引脚共面度、引脚间距精度、焊盘平整度、封装体翘曲度、气密性测试、湿气敏感等级(MSL)、温度循环耐受性、高温存储寿命、湿热老化试验、盐雾腐蚀试验、离子污染度、绝缘电阻、导通电阻、介电强度、信号完整性分析、X射线空洞率检查、超声波扫描缺陷探测、金线键合强度、胶体固化度评估、塑封料玻璃化转变温度(Tg)、吸湿率测定、可焊性测试
检测范围
QFP封装框架、BGA基板框架、CSP封装支架、LGA载板结构、SOP引线框架、DIP金属支架、QFN散热基板、FlipChip封装载体、MCM多芯片模块框架、铜合金引线架材样品、铁镍合金基板试样科隆钢框架试件科林合金支撑件铝碳化硅复合基板试片陶瓷封装基座试品环氧模塑料封装体试样聚酰亚胺薄膜覆铜板试件锡铅合金镀层试片化学镀镍钯金试样电镀银引脚试品激光切割毛刺试样蚀刻线路精度试件塑封成型收缩变形样品烧结银浆连接层试件金丝球焊点试样导电胶粘接界面试品底部填充胶固化试样散热片钎焊结合面试件湿气预处理的MSL分级样品高温回流焊模拟试样三防漆涂覆试件
检测方法
X射线荧光光谱法:通过特征X射线能谱分析金属镀层元素组成及含量
激光共聚焦显微镜:三维形貌重建测量引脚共面度与表面粗糙度
万能材料试验机:执行ASTME8标准进行拉伸/弯曲强度定量测试
热机械分析仪(TMA):测定材料热膨胀系数随温度变化曲线
扫描声学显微镜(SAM):利用超声波反射原理探测内部分层缺陷
<强>高加速应力试验箱(HAST):在130℃/85%RH条件下评估湿热老化性能
<强>四探针电阻测试仪:依据JESD22-C101测量导通电阻与接触阻抗
<强>红外热成像系统:实时监测功率循环下的温度分布均匀性
<强>氦质谱检漏仪:采用示踪气体法实现10^-9Pam/s级密封性检测
<强>动态信号分析仪:执行TDR时域反射测量验证高速信号完整性
检测标准
JEDECJESD22-B101E温度循环试验方法
IPC-6012D刚性印制板的鉴定与性能规范
GB/T2423.17-2008盐雾试验方法
IEC60749-25半导体器件机械与气候试验方法
MIL-STD-883K微电子器件试验方法标准
ASTMB912-00金属镀层孔隙率测试规程
ISO16750-4道路车辆电气电子设备环境条件
JISC60068-2-14环境试验基本规程
SEMIG61-0309晶圆级封装机械冲击测试指南
GB/T4937-2012半导体器件机械和气候试验方法
检测仪器
X射线荧光光谱仪(EDXRF):用于镀层成分分析与厚度测量
三维光学轮廓仪:亚微米级表面形貌与粗糙度量化分析设备
高低温循环试验箱:实现-65℃~150℃快速温变可靠性验证
精密坐标测量机(CMM):执行1μm级引脚间距与平面度测量
热重分析仪(TGA):测定塑封料热分解温度与吸湿率参数
<强>飞针测试机:非接触式电气导通/绝缘性能快速筛查系统
<强>聚焦离子束显微镜(FIB):微观结构截面制备与失效分析工具
<强>振动疲劳试验台:模拟运输或工作状态下的机械应力测试平台
<强>红外光谱仪(FTIR):材料化学结构分析与污染物鉴定装置
<强>纳米压痕仪:测量微米级区域的硬度与弹性模量特性
检测服务范围
1、指标检测:按国标、行标及其他规范方法检测
2、仪器共享:按仪器规范或用户提供的规范检测
3、主成分分析:对含量高的组分或你所规定的某种组分进行5~7天检测。
4,样品前处理:对产品进行预处理后,进行样品前处理,包括样品的采集与保存,样品的提取与分离,样品的鉴定以及样品的初步分析,通过逆向剖析确定原料化学名称及含量等共10个步骤;
5、深度分析:根据成分分析对采购的原料标准品做准确的定性定量检测,然后给出参考工艺及原料的推荐。最后对产品的质量控制及生产过程中出现问题及时解决。
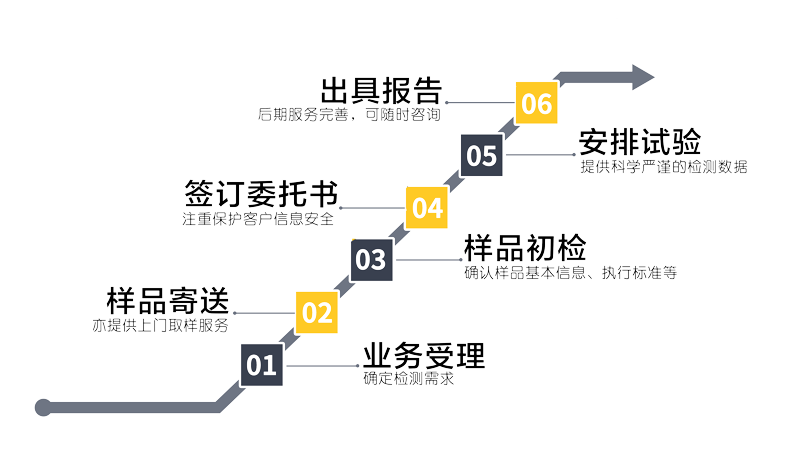
合作客户展示

部分资质展示
